解讀電子封裝無鉛化及晶圓凸點電鍍技術應用
2015-05-07 13:21:30
作者:本網整理來源:
無鉛化挑戰組裝和封裝材料
鉛的毒性已經廣為人知,人們雖然仍在爭論電子元件中的鉛是否真的對人類和環境造成威脅,但人們已經更為關注廢棄的電子器件垃圾中鉛的滲透并產生的污染。大多數歐洲聯盟成員國,已經在執行禁止在電子器件中使用鉛的法律。歐盟關于鉛等危險物的限制原則是盡量替換鉛,只有在“技術上無法替換”時才可以使用鉛。歐聯的無鉛法律將影響全球的電子產業,一來是由于供應鏈的全球化,再者也是由于在其它國家已經開始有類似的法律。為了實現無鉛化,人們需要對倒裝芯片封裝、晶圓級封裝、SMT和波峰焊進行廣泛的材料研究和工藝評價,需要為板上倒裝芯片和芯片級封裝技術研究合適的材料和工藝。
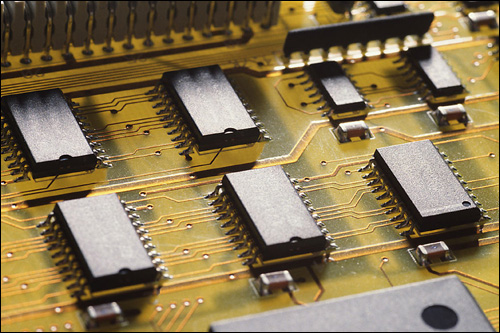
鏤板印刷制作凸點
用鏤板印刷或電鍍制作的晶圓凸點,顯示了無鉛在倒裝芯片和芯片級封裝和組裝領域的可行性。在凸點制備工藝中,需要給凸點底層金屬(UBM)覆蓋上新的焊材。印刷工藝之后,要在高于焊料熔點20℃的溫度下進行回流,然后再進行清洗和凸點檢查。UBM必須與新的焊料相匹配,采用化學鍍鎳工藝。晶圓加工是在一序列的化學池中進行的,在焊點清洗之后,緊接著進行的工藝包括:鋅酸鹽處理,表面活性化處理,鎳(5mm)的淀積,金層的生長。該項工藝為FraunhoferIZM與柏林技術大學合作開發。采用化學鍍鎳工藝的UBM穩定性好,良率高,已被廣泛使用。
焊膏印刷需要使用小間距模板、能適應微細間距要求的焊膏,以及優化的印刷參數。焊膏供應商已經生產了幾種無鉛焊膏,包括SnAg3.5、SnAgBixx和SnCu0.9。Sn95.5Ag4Cu0.5是共晶鉛焊料的替代品,工藝良率成功通過了與SnPb的對比測試。滾刷速度、模板剝離和檢查條件將決定產量。使用厚度為80mm的模板,能實現~110mm的凸點高度。使用SnAgCu0.5焊膏時,熔點溫度由183上升到217℃,相應的回焊爐的溫度設置也需從~205上升到235℃,典型的回流焊環境是使用氮氣,它可以將氧化降到最小程度。
同時,為了確保良好的工藝控制,必須對凸點制備中的晶圓實施自動檢測。最新的研究顯示對凸點實施非100%的測試也能滿足對凸點質量進行控制的要求,這樣還能減少檢測時間。SnAgCu凸點的光學檢測由于其粗糙表面(與以前的SnPb焊膏的光亮表面相比)的影響實,施起來不太容易,所以,這一步顯得更加關鍵,需要更加小心。拋開某些特例,成本核算表明,在FCOB的大批量生產中,用SnAgCu00.5替代SnPb的話,凸點制備工藝的成本可以達到低于每晶圓50美金。
迄今為止,倒裝芯片凸點技術仍然是技術的亮點。小間距芯片級封裝(>0.5mm間距)的出現,使得使用鏤板印刷方法,可能替代固體植球方法。
可靠性問題
世界正在邁向無鉛電子時代,汽車電子也對高熔點焊料提出了需求,這一切推動了產業對于新的焊料系統的選擇。對于新焊料系統,關鍵之一就是可靠性。SnAgCu與SnPb37相比,二者的疲勞壽命和失效機制基本相同,實際應用中,受熱歷程和焊點形狀決定疲勞壽命。研究等證明對于無電鍍鎳UBM,SnPb37和Sn95.5Ag3.8Cu0.7焊膏具有極佳的剪切性能。而且,底部填充料——PCB薄板上的倒裝芯片都需要它來保證可靠性——能減少焊點的大部分應力,因而也就延長了它的壽命。
倒裝芯片通常要使用兩次回流焊工藝,一次是在晶圓上球點的形成時,另一次是在組裝的時候。Ni3Sn4是無電鍍鎳UBM上的SnPb焊料以及SnAgCu焊料形成的金屬互化物。經過兩次回焊,金屬化后,Sn95.5Ag3.8Cu0.7的形態基本正常而且厚實。在較高的溫度下倒裝芯片的老化顯得十分關鍵。150和170℃時老化1000個小時,SnPb及無鉛合金會隨著鎳的消耗,轉化成小于2mm的Ni3Sn4。對于Sn95.5Ag3.8Cu0.7,其鎳的耗散厚度大約是SnPb的兩倍。同樣的,對于Sn95.5Ag3.8Cu0.7,在170℃而不是150℃時老化,鎳的厚度消耗會增加4倍。
在150℃環境里保存2000小時后,對焊接凸點的剪切力測試的結果表明,Sn95.5Ag4Cu0.5的剪切力大于SnPb37。而且,對于Sn95.5Ag4Cu0.5,經過高溫高濕(85℃和85%RH)保存,以及溫度循環(-40到150℃,1000cycles)之后,剪切力測試結果表明其可靠性比SnPb37稍好。對-40到125℃溫度循環后的倒裝芯片封裝進行測試,結果顯示Sn95.5Ag3.8Cu0.7的效果要好于SnPb37。但是Sn95.5Ag4Cu0.5的可靠性不如常規的SnPb37(循環溫度-55到125℃,及-55到150℃)。上述兩種情形,填充底料的選擇,熔化物殘留的多少,以及實際結合高度將決定哪一種連接方式更好。這表明合金的選擇對于產品的可靠性僅僅是第二號的因素。在150℃的環境下,現在流行采用含錫焊料。而在更高的溫度環境下,共晶的金錫(Au80Sn20)焊料或充銀焊料能支持到200℃。
CSP的連接通常不使用任何填充底料,人們希望無鉛焊料的較大的機械彈力能夠有效提高其器件的壽命。然而,必須注意的是,失效模式可能在厚的金相處由疲勞開裂轉為碎裂,或者金屬焊點會從底材分離,因為柔軟的SnPb的蔓延導致固體凸點中產生的應力無法得到釋放,只能通過彈性無鉛焊料傳遞到表面。
#p#副標題#e#
超細間距焊膏和無鉛焊料
晶圓凸點制備需要的是6型焊膏,它能確保焊膏均勻,因而減小回流焊后凸點高度的改變。與PCB板上傳統的SMT焊錫膏印刷相比,超細間隙焊膏的細小焊點,需要焊膏具有更高的粘性,對印刷性能、以及焊膏與模板的脫離有較大影響。增大的面積和體積比意味著焊料合金的氧化性增大,因而焊膏中氧化物含量較高,所以回流焊工藝需要氮氣保護。相同的技術適用于SnPb37焊膏,也同樣適用于三元或四元小間距焊膏。

晶圓凸點的電鍍
鏤板印刷的適用間距極限是150-200mm。對于間距小,凸點尺寸范圍寬的高互連密度的情形,電鍍技術是首選。FraunhoferIZM采用了間距小于40mm的電鍍工藝。國際半導體技術藍圖研討會(ITRS)預測,隨著倒裝芯片技術的發展,其凸點間距將呈現減小趨勢,對于高I/O芯片和高能芯片,減小的趨勢是,從2002年的160mm減小到2010年的90mm,2016年更減小到70mm。
電鍍時,凸點高度的均勻性要求在±1mm之內,這大大超過了鏤板印刷的均勻性指標。這是由于模板材料厚度和激光切割的精度變化較大,而且在模板的開口處會有少量焊膏殘留,其典型的變化范圍在±7mm。
電鍍的成品率損失在ppm量級甚至更低。按照失效標準的定義,從凸點高度均勻性的角度來看,電鍍比鏤板印刷的損失要小。因此,對于高產量,大尺寸IC來說,電鍍是一項低成本技術,而成品率的損失使得鏤板印刷失去了可比性。
電鍍時UBM要鍍上Ti/W/Cu,它們被均勻濺射在整個晶圓表面上,其后進行光刻,形成凸點焊點。鍍上的附加層銅,會被回流焊和金屬化合物熱應力部分地消耗掉。焊料金屬是以電化學的形式——基于甲基硫酸的方式——進行淀積。電鍍加工時間的長短取決于凸點的高度——與焊膏樓板印刷正好相反——即電鍍時間受限于較小凸點的高度。電鍍膜脫膜之后,以刻蝕方法去掉Ti/W/CuUBM。將晶圓上的淀積焊料回流,形成球形凸點,然后進行清洗,去掉有機殘留物。在FraunhoferIZM,人們完成了數種無鉛焊料的電鍍,并進行了深入觀察。SnPb焊膏的最佳替代是SnAg,因為它有某些特殊特性。銀的電極勢差較高,因而比起錫來更容易淀積。所以,需要對銀離子添加超強配位劑以抑制銀的過早淀積。
然而,Sn-Pb的二元相圖表明,焊料成分的小的差異并不會給熔點造成多大影響。而對于SnAg,影響卻十分明顯。含銀3.5%的共晶中增加一點點銀的話,熔點就會極大地升高。此外,FraunhoferIZM的研究還表明,對含銀4%時,大塊狀的Ag3Sn金屬化合物的生長更快,給互連的可靠性帶來嚴重損害。對于共晶SnAg3.5電鍍,電鍍池和合金成分的控制,顯得及其重要。三元合金的電鍍加工更加困難,甚至不予考慮。另一方面,由于UBM的銅電鍍層會部分溶解于SnAg,因此回流焊凸點總會包含SnAgCu合金,而且會受到回流焊溫度的影響。與SnPb相比,使用SnAg時銅電鍍基材的消耗更多。因此,提供的電鍍銅必需有一定的厚度。如果再考慮到加工成本的話,SnPb電鍍和SnAg電鍍沒有本質的差別。
總之,鏤板印刷的實現和電鍍晶圓凸點的制備代表了先進互連技術無鉛化的現狀,也證明了無鉛化技術是切實可行的。
責任編輯:李玲珊
《中國腐蝕與防護網電子期刊》征訂啟事
投稿聯系:編輯部
電話:010-82387968
郵箱:ecorr_org@163.com
中國腐蝕與防護網官方 QQ群:140808414
-
標簽: 電鍍技術
相關文章

官方微信
《中國腐蝕與防護網電子期刊》征訂啟事
- 投稿聯系:編輯部
- 電話:010-62313558-806
- 郵箱:fsfhzy666@163.com
- 中國腐蝕與防護網官方QQ群:140808414
點擊排行
PPT新聞
鋁合金LDH自修復自抗菌膜層構建
點擊數:466
碳鋼及合金鋼應用與區別
點擊數:393




